LED圓片級封裝(WLP)技術(shù)從哪里來
摘要:集成電路的快速發(fā)展,使芯片的集成度日益提高,從而使越來越多的產(chǎn)品采用半導(dǎo)體芯片。封裝是半導(dǎo)體芯片走向?qū)嵱没年P(guān)鍵步驟。廣義上的電子封裝是指對各種電子元器件的封裝和組裝,即包括一級封裝、二級封裝和三級封裝。狹義的電子封裝是指對半導(dǎo)體芯片或部件進(jìn)行保護(hù)。
1904年英國人弗萊明發(fā)明了世界上第*個(gè)電子管,這標(biāo)志著人類從此進(jìn)入了電子時(shí)代,此后電子管技術(shù)獲得了廣泛的應(yīng)用,世界上第*臺電子計(jì)算機(jī)“ENIAC”就是采用電子管制造的,但是人們在使用中發(fā)現(xiàn)電子管具有體積大、功耗大、發(fā)熱大、成本高、結(jié)構(gòu)脆弱、壽命短等缺陷。這就迫使人們研究更先進(jìn)的電子元器件代替電子管。
1947年,貝爾實(shí)驗(yàn)室的肖克利、巴丁和布拉頓發(fā)明了晶體管,人類從此進(jìn)入了微電子時(shí)代。電子產(chǎn)品中電子管逐漸被晶體管所取代,晶體管成為微電子時(shí)代的主流產(chǎn)品。
二十世紀(jì)六十年代集成電路技術(shù)的發(fā)展使得晶體管的小型化成為可能,在單個(gè)芯片上集成幾百個(gè)晶體管成為現(xiàn)實(shí)。晶體管尺寸的不斷縮小使單個(gè)芯片上集成的晶體管數(shù)目不斷增加,集成電路的規(guī)模也從小規(guī)模(SSI),逐漸發(fā)展成大規(guī)模、超大規(guī)模、甚大規(guī)模、吉規(guī)模,下表顯示了集成電路集成規(guī)模的發(fā)展。

集成電路的快速發(fā)展,使芯片的集成度日益提高,從而使越來越多的產(chǎn)品采用半導(dǎo)體芯片。封裝是半導(dǎo)體芯片走向?qū)嵱没年P(guān)鍵步驟。廣義上的電子封裝是指對各種電子元器件的封裝和組裝,即包括一級封裝、二級封裝和三級封裝。狹義的電子封裝是指對半導(dǎo)體芯片或部件進(jìn)行保護(hù)。
封裝主要有四大作用:第*,保護(hù)半導(dǎo)體芯片免受外界復(fù)雜環(huán)境的影響;第二,為芯片提供散熱通道;第三,為芯片提供機(jī)械支撐;第四,為芯片提供電連接。自從微電子技術(shù)誕生以來,芯片設(shè)計(jì)、芯片制造以及封裝和測試就成為微電子技術(shù)三個(gè)最重要的環(huán)節(jié),業(yè)界普遍認(rèn)為微電子產(chǎn)品總成本中,這三個(gè)環(huán)節(jié)各占三分之一。因此研究高可靠性的封裝技術(shù),對于提高產(chǎn)品成品率以及控制成本而言,具有重要的意義。
自從1947 年第*只晶體管誕生之日起,封裝也隨之應(yīng)運(yùn)而生。經(jīng)過 將近70年的發(fā)展,封裝技術(shù)獲得了長足的進(jìn)步,下圖所示為封裝技術(shù)發(fā)展示意圖。
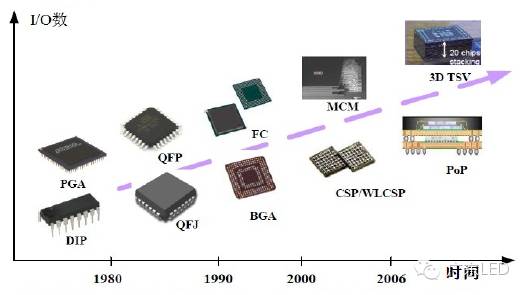
二十 世紀(jì)八十年代之前,半導(dǎo)體封裝主要采用雙列直插式封裝技術(shù)(DIP),管腳數(shù)4~64 個(gè)。主要采用穿孔技術(shù)安裝在電路板上。封裝密度低、效率低,難以滿足自動(dòng)化生產(chǎn)要求。
二十世紀(jì)八十年代出現(xiàn)了表面貼裝技術(shù)(SMT),與雙列直插式封裝技術(shù)相比較,表面貼裝技術(shù)主要優(yōu)點(diǎn)有:提高了封裝密度;縮小了元器件尺寸縮短了引線;改善了電性能;更適應(yīng)自動(dòng)化生產(chǎn)。典型的SMT 封裝技術(shù)包括方形扁平封裝(QFP)和四邊J形引腳扁平封裝(QFJ)。
二十世紀(jì)九十年代以后,由于人們對于產(chǎn)品小型化以及高集成度的要求日益強(qiáng)烈,隨之誕生了一些新型的封裝形式,如:球柵陣列封裝(BGA)、倒裝焊(FC)、芯片尺寸封裝(CSP)以及圓片級封裝(WLP)。最近幾年,又誕生了三維封裝技術(shù),這對于提高系統(tǒng)的集成度、增加封裝密度具有極其重要的意義,典型的三維封裝技術(shù)有芯片堆疊技術(shù)、封裝堆疊技術(shù)等。
圓片級封裝是采用IC工藝在圓片上進(jìn)行工藝加工并且進(jìn)行封裝和測試,相較于傳統(tǒng)的封裝技術(shù),圓片級封裝(WLP)技術(shù)由于具有較為顯著的優(yōu)點(diǎn),如圓片級封裝技術(shù)有較小封裝面積,降低了單個(gè)封裝體封裝、老化、測試的費(fèi)用等,近些年來一直受到人們的關(guān)注。
然而,圓片級封裝技術(shù)也有許多可靠性問題需要解決。不同的鈍化層材料、UBM層的布局和厚度都會對圓片級封裝產(chǎn)品可靠性造成影響。老化測試是評定圓片級封裝產(chǎn)品可靠性的重要手段,如何提高焊球抗老化性能具有重要意義。同時(shí),人們對綠色環(huán)保的呼聲日益高漲,造成了焊料無鉛化發(fā)展這一必然趨勢,研究發(fā)現(xiàn)無鉛焊料抗跌落性能較有鉛焊料差,這使得圓片級封裝產(chǎn)品跌落可靠性也值得我們關(guān)注。
來源:廣東LED
您可能感興趣的相關(guān)資訊
- 先進(jìn)封裝是否存在產(chǎn)能過剩風(fēng)險(xiǎn)?
- 三星發(fā)力“玻璃基板”封裝方案,計(jì)劃最早2026年量產(chǎn)
- COB封裝相關(guān)工藝流程
- 先進(jìn)封裝“三國殺”,傳統(tǒng)封裝廠商還有機(jī)會嗎?
- 裸眼3D掀戶外顯示新變革,產(chǎn)業(yè)重塑將引廠商跟進(jìn)升級
- 封裝、IC、顯示環(huán)節(jié)再次漲價(jià) 誰還坐得住?
- 芯片價(jià)格上調(diào)、Mini LED芯片小規(guī)模量產(chǎn)!兆馳披露了...
- 重磅發(fā)布 | Mini 0.9雙版本 全新上線,未來觸手可及
歡迎投稿
QQ:2548416895
郵箱:yejibang@yejibang.com
或 yejibang@126.com
每天會將您訂閱的信息發(fā)送到您訂閱的郵箱!















 陜公網(wǎng)安備 61019002000416號
陜公網(wǎng)安備 61019002000416號

 業(yè)務(wù)咨詢
業(yè)務(wù)咨詢